はんだや接着剤を使わない常温直接接合技術の開発
(連携研究センター 須賀 唯知)
整理番号:2019-004

研究者名: 須賀 唯知(Tadamoto Suga)
所 属: 連携研究センター 客員教授
専門分野: 界面、精密工学、実装工学、接合工学
キーワード: 精密工学、常温接合、表面活性化接合、半導体3次元積層
研究概要
1.背景(現在の問題点)
近年の高機能装置では半導体デバイスを高密度で集積し、実装することが高機能化、低コストの鍵を握ると言われている。従来タイプのSiウェハ接合は大気中で仮接合を行ったのち、300℃以上の高温加熱処理をすることにより接合を実現するが、熱膨張の異なる材料を高温で接合すると、熱膨張の差で大きなひずみが生じ、そのままでは接合できない場合や、強度が不十分、信頼性が確保できない場合などがあり、低温接合へのニーズが大きくなっている。
2.技術(本技術の概要)
本研究グループでは従来の接合・接着の代わりに、表面活性化接合(Surface Activated Bonding :SAB)を用いることで常温での直接接合を実現しており、様々な材料での実装を試みている。
常温接合は真空中で接合対象の表面の酸化膜や吸着層をイオンなどのエネルギー粒子の照射によって除去し、その表面を活性化することによって、固体表面が本来持っている凝集エネルギーをそのまま接合の駆動力に利用する接合方法である。またSiなどのナノ密着層を用いて、金属だけでなく、半導体、セラミックス、プラスチック、ダイヤモンドなどのさまざまな異種材料の接合が可能となっている。
3.本技術の特徴
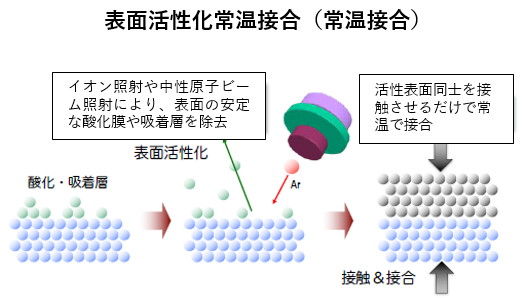
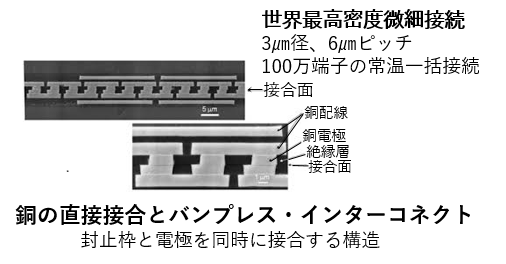
金属と金属、金属とセラミックス・ガラス、金属と半導体、同種・異種の半導体を対象として常温で直接接合を実現。
・高いスループット・高いアライメント特性
・熱ダメージ、熱ひずみ
・界面での反応(ボイド発生等)なし
・高い材料選択の自由度
応用例・用途(相談に応じられる分野)
■3D集積化のための常温接合
■MEMSパッケージへの適用
■常温ウエハ接合による部品製造
研究設備・備考
■ 常温接合装置
